반도체
리드프레임 표면처리
목적
전자제품 실장성(납땜성) 향상
산화방지를 통한 부품의 수명 향상
친환경 표면처리(무연합금)
Process
Electro Deflash
(전해탈지)
Water Jet
(고압수세)
Descale
(산세정)
Electro Plating
(전기표면처리)
후처리
(중화,수세,건조)
LED 가공 공정
목적
PKG 성형 중 발생되는 이물질 가공처리
Process
Electro Deflash
(전해탈지)
Water Jet
(고압수세)
Descale
(산세정)
Assembly
Process
FAB
ASS’Y

Back Grinding
웨이퍼 뒷면
Grinding

Sawing
웨이퍼 절단하여 개별단위로 분리

Die Attach
리드프레임 위에 칩을 부착

Wire Bond
리드와 칩을 금선으로 연결

Molding
칩 보호를 위해 EMC로 봉합

Metal Finish
Lead Frame 산화방지
전도성 및 납땜성 향상

Trim / Form
개별단위 반도체로 분리 절곡
TEST


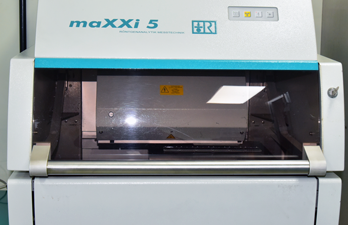

| Package | Electro Plating | |||
|---|---|---|---|---|
| Composition | Thickness | Length | Width | |
|
TSOP(I,II), QFP, SOIC, PLCC, DIP Power Module LED Sensor |
Pure Tin Tin Bismuth Au Plating |
4~25 ㎛ |
150~250 ㎜ |
30~75 ㎜ |